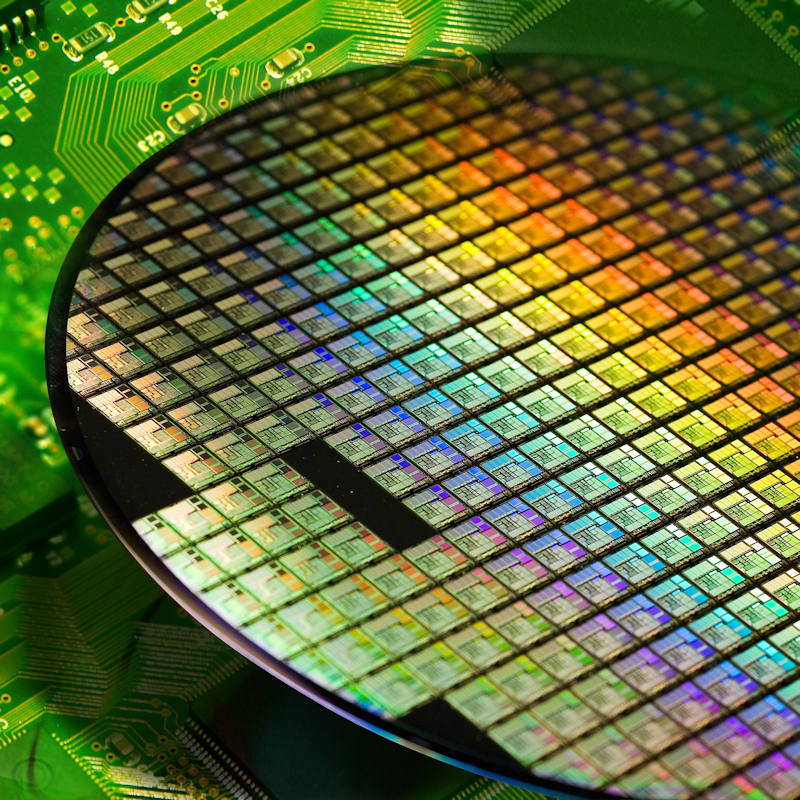
XRF, XRD y XRR para caracterización de película delgada
Dentro de la industria de los semiconductores, existe una demanda continua de Circuitos Integrados (IC) que entreguen un mayor rendimiento a un menor costo que sus predecesores. Las herramientas de metrología de obleas se utilizan para diseñar y fabricar Circuitos Integrados, controlando cuidadosamente las propiedades de la película, los anchos de línea y los posibles niveles de defectos para optimizar el proceso de fabricación de estos dispositivos. Las herramientas de metrología combinadas con las capacidades de inspección de obleas garantizan un enfoque apuntado a las propiedades físicas y eléctricas de los dispositivos semiconductores en producción. La metrología de obleas puede identificar específicamente partículas de la superficie, defectos de patrones y otras condiciones que podrían causar efectos adversos en el rendimiento de estos dispositivos.
Rigaku es pionero y líder mundial en el diseño y fabricación de herramientas de medición basadas en rayos X (difracción de rayos X, fluorescencia de rayos X y reflectometría de rayos X) para resolver los desafíos de la fabricación de semiconductores. Con un liderazgo de casi 30 años en el mercado global en la industria de semiconductores, nuestras familias de productos permiten todo, desde la metrología de control de procesos en fab hasta la I+D para la caracterización de materiales y películas delgadas.
Application notes
The following application notes are relevant to this applicationXRD
Rigaku recommends the following systems:
X-ray topography (XRT)
Un sistema de topografía de rayos X de laboratorio rápido y de alta resolución para la reproducción de imágenes de dislocación no destructiva
SAXS
Un sistema Kratky 2D modernizado que elimina las correcciones de datos requeridas por los sistemas tradicionales
XRD
Sistema avanzado de rayos XRD de alta resolución y tecnología de punta, impulsado por el software del sistema experto Guidance
X-ray CT
Semiconductors
Metrología de contaminación de la superficie elemental traza por TXRF; obleas de hasta 300 mm
Metrología de contaminación de superficie elemental ultratrazas por TXRF con capacidad VPD; obleas de hasta 300 mm
Espectrómetro WDXRF simultáneo en línea para la metrología de película de metal de obleas; obleas de hasta 300 mm.
Espectrómetro WDXRF simultáneo para la metrología de obleas de película de metal; obleas de hasta 200 mm
Espectrómetro secuencial WDXRF para el análisis elemental y la metrología de película delgada de muestras grandes y/o pesadas
Herramienta de metrología de procesos XRR, XRF y XRD para obleas con y sin patrones; obleas de hasta 300 mm.
XRF y herramienta de metrología óptica para obleas planas y obleas con patrones; obleas de hasta 300 mm














